
El sistema de eliminación de residuos por plasma PD-200 ICP integra una fuente de RF de 13.56 MHz (hasta 2 kW) para la eliminación controlada de fotorresina y residuos en procesos de semiconductores. Admite el manejo de múltiples obleas, control preciso de temperatura hasta 250°C y uniformidad ≤5% para un rendimiento de producción estable.
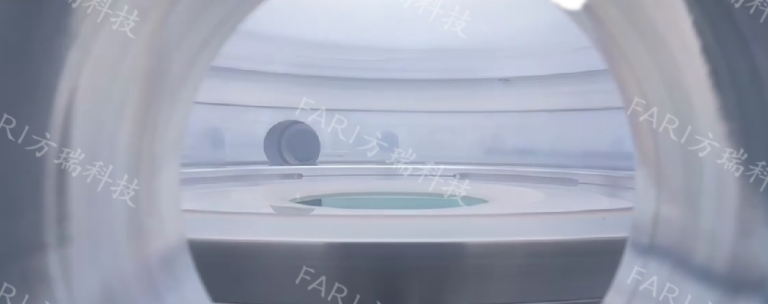
| Modelo | PD-200 |
| Fuente de Plasma | RF 13.56 MHz |
| Potencia de RF | 2 kW |
| Tamaños de Oblea Aplicables | 2", 4", 6", 8" |
| Manejo por Lotes | Múltiples obleas (solo para obleas de 2" y 4") |
| Dimensiones (L×A×A) | 673 × 1455 × 1695 mm |
| Configuración de la Cámara | Cámara de transferencia + cámara de proceso |
| Control de Temperatura del Proceso | 50–250 °C |
| Uniformidad | ≤5% (borde excluido 10 mm, medición de 5 puntos) |
| Eliminación de PR por Plasma | ≤90 °C; 50–100 nm/min; uniformidad ≤5% (prueba de 5 regiones) |
| Incineración a Alta Temperatura | ≤250 °C; 3000–5000 nm/min; uniformidad ≤5% (prueba de 5 regiones) |
| Control del Sistema | Sistema de control FR (sistema FR / FangRui) |
| Nivel de Automatización | Manual + semiautomático |
| Enfriamiento de Electrodo / Enfriador | Enfriamiento de electrodo FR-600A-H |

Inglés

Español
Rogatus ad ultimum admissusque in consistorium ambage nulla praegressa inconsiderate